芯片粘贴小型芯片焊机
{{product.productLabel}} {{product.model}}
{{#if product.featureValues}}{{product.productPrice.formattedPrice}} {{#if product.productPrice.priceType === "PRICE_RANGE" }} - {{product.productPrice.formattedPriceMax}} {{/if}}
{{#each product.specData:i}}
{{name}}: {{value}}
{{#i!=(product.specData.length-1)}}
{{/end}}
{{/each}}
{{{product.idpText}}}
{{product.productLabel}} {{product.model}}
{{#if product.featureValues}}{{product.productPrice.formattedPrice}} {{#if product.productPrice.priceType === "PRICE_RANGE" }} - {{product.productPrice.formattedPriceMax}} {{/if}}
{{#each product.specData:i}}
{{name}}: {{value}}
{{#i!=(product.specData.length-1)}}
{{/end}}
{{/each}}
{{{product.idpText}}}

... Datacon 2200 evo 高精度多芯片贴片机为贴片以及倒装芯片应用提供了最大的灵活性。Datacon 2200 evo配备了集成分配器、12英寸晶圆处理、自动换模器和特定的应用工具,为当前和未来的工艺和产品做好准备。 高精度下的高性能 最高精度± 10 µm @ 3 Sigma (根据要求为7 µm) 高生产力,低拥有成本 一台机器最多可容纳4个工作头 多芯片能力 复杂产品的单程生产 在一台机器上进行贴模、倒装芯片、多芯片生产 环氧树脂书写和冲压,焊剂浸渍 ...
BE Semiconductor Industries N.V.

... Datacon 2200 evo plus die bonder for Multi Module Attach在一个久经考验的平台上装配了各种技术,其主要功能是提高粘合精度和降低拥有成本。 除了无与伦比的灵活性和完全定制的可能性外,这台进化的机器还通过新的摄像系统和热补偿算法提供了更高的精度和长期稳定性,通过新的图像处理单元提供了更高的速度,并提高了洁净室能力。 更高的精度 更高的生产力 更高的灵活性 多芯片能力 灵活定制 开放式平台结构 集成式分配器 可提供压力/时间(Musashi®)、螺旋桨、喷射器类型 环氧树脂冲压选项 填充和未填充的环氧树脂,粘度范围广 占地面积小,拥有成本低 新的高速图像处理单元 完全对准和不良标记搜索 预先定义的靶标几何形状&定制教学 自动晶圆和工具交换器 用于多芯片生产的全自动化循环 多达7个取放工具(可选择14个),5个弹出工具 可使用冲压工具和校准工具 在一台机器上进行贴模、倒装芯片和多芯片生产 取模:晶圆、华夫包、Gel-Pak®、进料器 模具放置到:基材、船、载体、PCB、引线框架、晶圆上 支持热和冷工艺:环氧树脂、焊接、热压、共晶 ...
BE Semiconductor Industries N.V.

... 创新产品的创新解决方案用 于多模块附加的 Datacon 2200 hs 模具粘合机将各种技术组装在一个久经考验的平台上,通过增强关键功能,提高了粘合精度和更低的拥有成本。 除了不败的灵活性和完全定制的可能性外,这款演进型机器还采用新的摄像机系统和热补偿算法,提供更高的精度和长期稳定性,通过新的图像处理装置提高了速度,并改进了洁净室功能。 数据通 2200 埃沃去 HS! -多芯片能力 -定制灵活性 -开放平台架构 主要功能 多芯片 -多芯片生产的全自动循环 -多芯片生产-多达 ...
BE Semiconductor Industries N.V.

... 为您的大规模生产提供精确性和灵活性 新的Datacon 2200 evo advanced是Besi的多模块附件平台的最新版本,具有全新的龙门和控制器系统以及全新的视觉和摄像头,Datacon 2200 evo advanced提供了3μm的超高贴装精度,同时仍然关注您的生产力和产量要求。 在大幅提高精度和贴装能力的同时,Datacon 2200 evo advanced并没有忘记它在多模块附件系列中的根基。它仍然提供Datacon 2200 evo平台众所周知的无可匹敌的灵活性以及完全的定制能力。 ± ...
BE Semiconductor Industries N.V.

... Die Bonder Esec 2100 hS是第三代最灵活的300毫米高速平台,能够运行广泛的环氧树脂芯片连接应用,如QFN、TSOP、QFP、BGA、CSP-BGA、SiP-BGA、FBGA和LGA。它是运行、协助和控制生产的最轻松的系统,以最低的拥有成本实现了产量和收益的飞跃。在推出时,这一创新的平台概念赢得了著名的瑞士技术奖。 领先的机器概念 通过加工区的4个实时图像进行实时过程监控 通过实时的晶圆、带材和料仓查看器进行持续的状态控制 通过上下文敏感的在线帮助,实现高效的学习和错误恢复 通过4个加工区的实时图像进行实时过程监控 通过实时晶圆、带材和弹夹查看器进行持续的状态控制 通过上下文敏感的在线帮助实现高效的学习和错误恢复 20微米精度下的最高速度 革命性的Phi-Y概念结合了旋转和线性运动,使取放周期非常短 新的 ...
BE Semiconductor Industries N.V.

... Esec 2009 SSIE 新型贴片机专为应对电源贴片领域即将面临的所有挑战而设计。其前所未有的生产率和工艺控制在业内无与伦比。Esec Die Bonder 2009 SSIE 采用专利软焊接工艺技术,确保您在市场上处于领先地位。 2009 SSIE 是市场上唯一能够处理 300mm / 12" 晶圆(可选)的软焊贴片机。 主要特点 最高速度 - 新型点对点取放技术 - 高速高精度点胶技术 最佳工艺质量 - 耗气量最低 - ...
BE Semiconductor Industries N.V.

... 热压焊接是当前 2.5D/3D C2S 和 C2W 封装的关键技术,而 TC-CUF 则是目前 3D 存储器应用的成熟工艺。 Datacon 8800 TC advanced 基于成熟的 8800 概念,凭借全面的工艺控制、先进的功能和无与伦比的生产稳定性,树立了新的标杆。Datacon 8800 TC advanced 凭借其独特而完整的全新先进硬件架构、独特的 7 轴键合头和先进的工艺能力,成为当前 TSV 应用的重要参考工具。 Datacon 8800 TC ...
BE Semiconductor Industries N.V.

... 倒装芯片贴片机 Esec 2100 FC hS 是市场领先的第三代高速 FC 平台,能够运行广泛的 FC 应用,如 FCOL、FC-MIS、FC-SIP、FCCSP、FCBGA 以及 CSP-LED 等新兴封装。它是运行、辅助和控制生产最轻松的系统,能以最低的拥有成本实现吞吐量和产量的飞跃。 主要特点 8 微米精度下的最高速度 - 包括浸渍助焊剂在内的 UPH 高达 12k - 革命性的 Phi-Y 概念结合了旋转和线性运动,因此拾放周期极短 ...
BE Semiconductor Industries N.V.

... iSTack™ S+ 专为高端环氧树脂和薄膜模具附着应用而设计,具有工艺灵活性,可支持存储器和图像应用。 其增强的工艺特性包括面朝下工艺、原位紫外线和粘合力检测机制,可提高生产率和性能。 特性和选项 高精度套件 (5 μm) 薄基板处理套件 (< 100 μm) 映射功能 (基板/晶圆) 晶圆/基板污染去除套件 OHT/AGV 套件 MEMA 套件 UV (原位/粘合后) 工具污染监测套件 ...
Kulicke & Soffa

... 随着连接较薄的模具和基板的新兴趋势,iSTack™ W+ 为晶圆级模具附加提供了解决方案。 特性和选项 高精度套件(5 μm) 映射功能(基板/晶圆) 晶圆/基板污染去除套件 OHT/AGV 套件 UV(原位/粘合后) 工具污染监测套件 ...
Kulicke & Soffa

ACCμRA M是一种手动倒装焊机(flip-chip bonder),其精度可以达到±3微米。该设备能够对元件进行高精度地手动对准。 电动臂可以对接合力进行精确控制。将电动臂与温度控制器进行结合并同步,确保您的加工过程具有完美的质量和高重复性。 ACCμRA M不仅是一个取放系统,它还具备热压和回流焊功能。 是适于大学和研发机构使用的完美设备。 • ±3微米 • 占用很少的资源 • 手动机器 • 使用方便 • 开放性平台 • 研发型 工艺能力 • ...
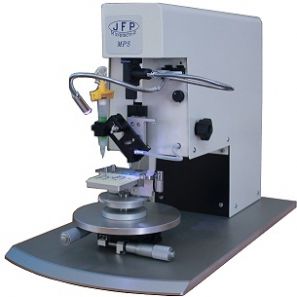
... MPS:用于小芯片和 SMD 零件装配 应用: 模具装配平台和小型 SMD 贴装 实验室和原型(实验室,珠宝,手表,SMD,BGA,..) 小型零件处理能力 焊膏 SMD 回流共 晶模粘接 高精度选取和放置非常小巧的设备 设计提供了一个简单的粘合解决方案,适用于 超高清摄像机 真正的垂直运动 侧摄像头兼容视频界面:可倾斜于任何角度 高可靠的工具。 无需培训。 特点/参数: 低采摘力:< 10 克 可调节粘合力 摇头,点胶/冲压 功率:100/230 VAC ...
为提升搜索质量,您认为我们应改善:






请说明:
您的建议是我们进步的动力:
剩余字数